| 电路设计 单片机学习 PCB设计 电子制作 电工基础 电路基础 电子电路图 电脑技术 维修教程 手机数码 家电维修 电力技术 电气技术 |
| 电子基础 arm嵌入式 集成电路 模拟电子 电源管理 显示光电 楼宇控制 安防监控 控制电路 音响功放 单元电路 电子下载 维修资料下载 |
中介层(Interposer)可以在堆叠芯片中再分布互连线,它在采用穿透硅通孔(TSV)的3D集成商业化进程中正扮演着越来越重要的角色,日前在日本东京附近举行的JissoForum2008上有与会者这样宣称(Jisso是日本语,代表各种封装技术)。
例如3-D集成会将存储芯片和逻辑芯片的焊垫进行阵列。论坛上专家表示,尽管长期目标是采用标准的焊垫尺寸和位置来集成芯片,但是标准实现还有些困难。在过渡期,再分布互连层的中介层将充当连接芯片和不同位置及尺寸的焊垫的角色。
若没有中介层,堆叠IC的电极焊垫将必须非常精确地阵列,这样就限制了设计的自由度。如果芯片设计者不得不统一焊垫布局和尺寸,他们将被迫调整其设计,在性能和功能上寻求折中方案。中介层允许两层芯片的焊垫进行再分布互连,在许多案例中通过中介层上表面承担存储芯片焊垫设计,而下表面则承担逻辑芯片焊垫设计。
在Jisso论坛上,东京大学的教授TakayasuSakurai表示,3-D芯片集成通常需要再分布层来调整TSV的位置和材料间的差异。他指出,在存储芯片和逻辑芯片的相同位置来制作TSV具有相当的难度。本田研究院(Honda
ResearchInstitute)主管NobuakiMiyakawa表示,尽管采用中介层可能导致成本的增加,但TSV能极大提升性能至20-30%,减少30-40%的功耗。
瑞萨科技高级工程师TakashiKikuchi表示,更薄的芯片是采用TSV的驱动力。瑞萨比较了采用中介层及TSV的3-D芯片和传统的引线键合倒装芯片。传统芯片1.25mm高,而新开发的采用TSV和中介层的芯片只有0.6mm。在两种封装尺寸的测量中,都包含了焊球的高度。
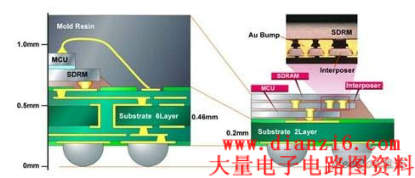
瑞萨科技的一份研究将采用中介层的TSV互连芯片堆叠(右)与传统倒装芯片连接(左)相比较。
瑞萨传统的系统封装(SiP)是在6层衬底上将引线键合的微控制器集成到倒装芯片封装的SDRAM上,并进行塑料树脂包封。最新开发的SiP则通过TSV将SDRAM芯片与底部的微控制器连接起来,它与两层的衬底互连。Kikuchi指出,高度的降低主要因为减少了互连的衬底层。
 温馨提示; 本站的资料全部免费下载,为方便下次找到本站记得将本站加入收藏夹哦,牢记网址http://www.dianzi6.com
温馨提示; 本站的资料全部免费下载,为方便下次找到本站记得将本站加入收藏夹哦,牢记网址http://www.dianzi6.com|
此页提供中介层在3-D集成IC中发挥重要作用电子电路基础,模拟电路基础, 电路基础参考。本站还有更多的电路基础相关资料分享。
Copyright© www.dianzi6.com Inc. All rights reserved 。 1 2 3 4 5 6 7 8 |
|