| 电路设计 单片机学习 PCB设计 电子制作 电工基础 电路基础 电子电路图 电脑技术 维修教程 手机数码 家电维修 电力技术 电气技术 |
| 电子基础 arm嵌入式 集成电路 模拟电子 电源管理 显示光电 楼宇控制 安防监控 控制电路 音响功放 单元电路 电子下载 维修资料下载 |
本文将说明批量诊断结果与DFM热点相关联如何成为一种高效率的手段,以找到设计中的“问题区域”,为制造与设计团队提供通行令让他们可以减少系统性瑕疵。
批量良品率诊断(VYD)
芯片良品率的提高是纳米级半导体公司面临的最大挑战之一,它对整个电子工业的经济影响关系重大。
业内过去一直在使用三种传统方法以提高良品率。线路内检查与电气测量是过去用于识别与提高良品率的两种最主要手段。第三种提高良品率的手段是使用ATE中收集到的故障数据。这种提高良品率的方法可以有非常高的效率,因为,(1)通过单个扫描链可以测试数百万门;(2)可以将逻辑诊断结果与实际设计与布局数据相关联。本文将会解释基于这第三种技术的VYD,在其中分析大量的ATE数据,以寻找纳米设备的系统性缺陷行为。
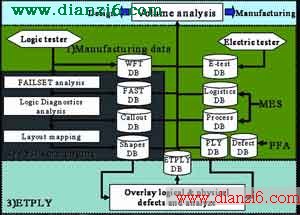
图1 良品率学习系统流程
1 良品率学习系统流程
图1展示了一个良品率学习系统流程的实例。分析是通过收集尽可能多的有效数据进行的,其数据库来自:
(1)包含制造条件等的生产数据,以及监控数据与设计数据;
(2)VYD核心引擎。
VYD核心引擎中的DB包括wafer lot、芯片名和坐标、已找到位置的线网名、线网形状、单元类型以及显示各诊断预报最高分的故障模型。制造DB包含测试条件、制造执行系统(MES)、物理故障分析(PFA)和将电气诊断(位图、逻辑线网诊断预报)与线路内PLY数据重叠的电气测试处理限定良品率(ETPLY)。
批量良品率诊断可以针对典型故障样本迅速执行诊断仿真,以识别和区分最常见的故障类型与位置。VYD能够透彻地鉴别最关键的良品率问题,让设计与制造人员能够及时解决良品率损失问题。批量良品率诊断需要大量特定功能,包括故障数据分析、并行运行时间支持、无故障终止、自动故障挑选以及一个数据提取编程界面。

图2 VYD引擎流程
2 VYD引擎流程
图2显示了核心诊断引擎的VYD流程。批量诊断作为VYD系统的一部分,能够迅速分析大量的器件故障,通过单元类型、IP模块、线网、金属层或测试序列等识别常见的故障模式。VYD为多个wafer lots中的单种设备类型挑选并分析数量庞大的(有时是成百上千个)典型故障。收集了批量诊断的大量有效数据后,测试与诊断过程按照下面三个步骤展开。第一步是从测试者中收集数据。我们可以获取通过或者失败的信息,其中显示了wafer lots级别中芯片的各种趋势,并附有测试者状况。测试者可以在几乎所有ATE都支持的STDF中对其进行格式化。第二步是对故障集进行分析,其中包含故障样式数量,以及从测试者日志中提取的故障位置。大量的故障集显示了扫描链、故障类型和FF单元类型的趋势。第三步是分析累积诊断的“诊断预报”报告。诊断引擎会建立一个“诊断预报”报告,根据与ATE观测到的故障行为的匹配程度,对内部节点与故障机理进行排列。此外,各引擎会将“诊断预报”列表写入到诊断数据库。对得出的数据进行绘制,确认是否存在统计上的相关趋势。
分析中可以含有判断是否有特定的元件类型或临界结构造成巨大良品率损失的报告。
特定故障集的诊断预报结果被分为三种类型(TFSP、TFSF和TFSP),如图3所示。瑕疵的可能性使用以下数学方程式计算。
Score=(TFSF/(TFSP+TFSP +TPSF/10))*100 (1)
(Cadence制定的逻辑诊断分数计算)
分数显示为100,表示诊断预报结果与故障仿真和故障集(如TFSP和TFSP为空)的结果完全一致。
确认了良品率限制因素后,代表良品率限制因素的故障盘片就会被确认,这样就可以让故障分析(FA)设备显示单个盘片上准确的物理故障位置/结构。
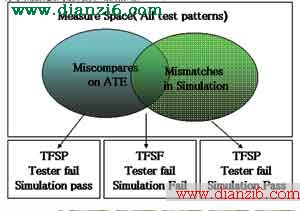
图3 诊断预报分值计算公式
该流程中的最后一个步骤是进行精确诊断,其目标是VYD发现的最重要的故障。在诊断预报未能达到物理故障分析(PFA)能够执行的高分值的情况下,故障集将会重新生成,诊断仿真将会采用更复杂的故障模型运行。
VYD分析
VYD分析的要点是如何从故障集和诊断预报中提取引人注意的要点。大量的故障集与wafer lots可以分析扫描链错误率、双稳态多谐振荡器、顶层错误双稳态多谐振荡器、错误图样分析、常见故障类型以及初始错误样式等。大量的诊断预报可以分析单元类型以及高分值的线网名。

图4 故障扫描链总结
1 故障集分析:扫描链
对ATE上出问题的扫描链的故障集进行分析,发现故障的原因。图4显示了扫描链,根据芯片的盘片样本数值,其故障数最高。
根据批量分析的结果,可以看到在所有盘片中有3条扫描链在ATE的测试中至少发生了3次故障。由于盘片样本总数很少,这个结果还不够有说服力,还无法指出特定的系统行为或原因所在。如果在这里能够提高样本数量,那么分析的结果将会为我们指出更精确的系统故障行为。

图5 扫描链分析结果
图5描述了所有逻辑故障数据集的批量逻辑诊断分析结果。
如上图5所示,扫描链48与扫描链54在大多数时候都会出现问题。这些故障行为只有在特定故障盘片上可以看到。稍微加以分析就会发现,所有故障都是发生在扫描链35中的bit 613上。这就为我们指出了一个系统性错误。在进行诊断之前分析故障数据,就可以缩短执行诊断所需的处理时间。
2 诊断预报分析:单元类型
图6显示了诊断预报分析的案例分析。图表是从大量故障与较低比率的设计中整理出来的。因此最左端的条代表的单元类型是单元模型中最有可能出现的瑕疵。

图6 单元类型分析结果
精确诊断技术
在新技术的低良品率阶段或初期阶段,故障芯片通常会包括多个瑕疵或更复杂的瑕疵。这会导致在诊断仿真中出现低分值,即便是提前进行了划分,想要找到低良品率的原因更加困难。
对于这种情况,精确诊断有一些解决方案。其他诊断功能比如SLAT分析、版图的额外故障推举或者诊断硬件和高级划分技术都是十分有效的。工程师有时会采用其他划分技术以锻炼测试条件或样式生成的灵活性。
批量分析与DFM连接:探测有缺陷位置的更高精确性
随着工艺技术的缩小,诊断系统故障的难度越来越高。这种现象的一个原因是造成纳米故障的原因没那么容易使用固定故障模型预测。例如,桥接故障(bridging failures)或者金属线或金属和聚乙烯之间的短路就是会导致芯片上的两条不同线路通电的瑕疵。桥接故障通常是由于生产过程中掺入了杂质粒子,或者因为印刷错误的光刻所导致。
提高故障诊断精确度的可制造性设计(DFM)的备选方案是使用DFM工具分析物理设计,以确认最有可能与桥接瑕疵有关的成对的线网。寻找物理上与其他线网临近的线网就可以确认。这种分析的进行方式是使用DFM关键区域分析(CAA)工具对“关键区域”进行计算。成对线网之间的面积被定义为关键区域,其中极小的一部分就有可能造成两个线网之间的桥接。知道了关键区域之后,成对线网可以按照关键区域分类,关键区域最大的前N个线网可以用来建立实用的桥接故障模型,使用于诊断中。
可以采用的另外一种方法是使用一个设计规则检查器(DRC)找出只有单个导孔的线网。可以对这些线网做标记,建立一个开放故障模型模仿未填充或者缺少的导孔。如果诊断出存在导孔问题,在诊断中使用这种模型最有可能获得更高的诊断预报分值。
最后一种方法是同时使用DFM与诊断,如图7所示。在这种情况下,热点来自以下来源:
①来自光刻仿真器的光刻热点。
②光学临近校正(OPC)热点
③来自CMP仿真器的化学机械抛光(CMP)热点
④CAA热点
⑤版面中的连通性热点,例如:关键时序路径
⑥Cadence Encounter Diagnostics输出的诊断预报线网
⑦物理验证系统(PVS)-DRC热点与标记
将热点位置(X,Y)与诊断诊断预报位置相关联,可以用于计算诊断预报分值,就像公式(1)说明的一样。这可以让位置与光刻热点相同的诊断预报线网比起与热点隔离的诊断预报分值更高。其理论依据是光刻热点造成故障的可能性高于远离光刻热点的诊断预报。
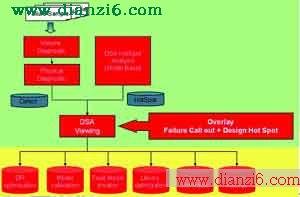
图7 Design to Silicon瑕疵分析
这种对诊断诊断预报与热点的关联可以被看到,并连接到版面中的相应位置,帮助驱动PFA设备。
数据累计
将特定单元类型或版面布局故障率的历史数据累积起来,即堆叠导孔M3到M5与对应的热点可以从批量诊断结果中剥离,将其规格化并分析,让高良品率损失的情况得以反馈给设计团队,以修改设计库,限制他们的使用,或者降到最低,在设计验证中对其进行标记。
此外,根据错误的关键范围(CD)造成的大量诊断预报与热点关联的位置,还可以自动产生CD-SEM处方。有了这个处方再加上历史数据,可以实现及早预防。
结束语
随着EDA工具的进化,诊断仿真被不断改进,从而能够比五年前更快地侦测纳米设备中复杂的瑕疵位置。加上批量良品率诊断,这种方法学变得更为实用,通过从多个wafer和wafer lots中收集测试结果,找出系统性瑕疵的常见原因。
为了解决不可见瑕疵与细微的设备与金属变化这个越来越大的问题,诊断预报可以与热点和设计信息相关联,有助于更为一目了然地指引PFA流程,并限制需要在PFA中探索的面积――只要检查与热点高度关联的线网片段即可。
最后,诊断预报与热点的相关因素也可以使用于诊断预报计算器,以提高诊断工具计分的精确性。配合诊断与DFM能够找到系统性良品率损失最细微原因的所在位置。
 温馨提示; 本站的资料全部免费下载,为方便下次找到本站记得将本站加入收藏夹哦,牢记网址http://www.dianzi6.com
温馨提示; 本站的资料全部免费下载,为方便下次找到本站记得将本站加入收藏夹哦,牢记网址http://www.dianzi6.com|
此页提供使用诊断与DFM提高可制造性eda技术,eda技术实用教程, EDA/PLD参考。本站还有更多的EDA/PLD相关资料分享。
Copyright© www.dianzi6.com Inc. All rights reserved 。 1 2 3 4 5 6 7 8 |
|